2.1 联栅是什么
2018年杭州优捷敏半导体技术有限公司提出一种新型功率器件——联栅晶闸管,英文名称Gate Associated Thyristors,简称GATH。
联栅的“栅”是交叉栅,跟发射极金属层正交的浓基区。
联栅把功率管分割成许许多多的细小元胞。比原来的BJT和GTO的元胞多10--100倍,元胞的周边总长度增加10-100倍,周边的电流密度降低了1-2个数量级,电流集边效应减弱了1-2个数量级。从而解决了电流型功率器件的主要问题——BJT的二次击穿、GTO的dI/dt和dV/dt限制。

图2-1 GATH图像
2.2 GATH对功率器件的改进2.2.1 GATH的结构
GATH是一种特殊的SITH/BJT,即采用多晶硅发射极的静电感应晶闸管与双极晶体管的复合功率管。其特点是浓栅代铝,元包细微。图2-2是GATH的结构示意图,蓝色的一层是多晶硅发射极,P+浓掺杂栅区的上面没有铝层,栅区汇流条上面才有铝层,如图2-3所示。

图2-2 GATH结构示意图 图2-3 GATH电子显微镜照片
(1)宽的长条是由许多长方形的元胞组成的条带,上面连接发射极金属层
(2)窄的长条是浓基区(栅区)汇流条,上面连接栅极(基极)金属层
2.2.2 GATH的工作原理
GATH的工作原理可以看作是一种IGCT。
GATH的栅区上面没有铝层,因此,元包能够做得很小,只有IGCT的千分之一。
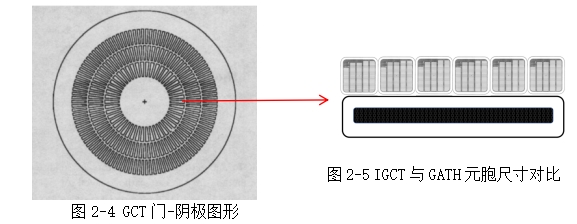
图2-4是IGCT的图像,图3-5是IGCT图像与GATH图像尺寸对比。IGCT的一个元包就是一个台面加周边,其尺寸大小相当于GATH的有源区X方向排列6个。
2.2.3. GATH改进元胞变小解决了什么问题
(1)降低IGCT的开关功耗,驱动简单,成本降低
GATH的元包细小,容易开关。其关断驱动功耗仅为IGCT的10%,而且能够安全关断GATH十倍的电流。
(2)关断电流大于IGCT

图2-6 GATH的关断波形照片
图2-6是GATH 1200V 20A的关断波形照片。从中能够看到,电流峰值50A,功率管的壳温200°C。该功率管的有源区面积是2mm*2mm,GATH的关断电流密度达到1200A/cm2,远远高于IGCT的80A/cm2。
(3)抗雪崩能力超过IGBT
IGBT的主要失效模式是过电压雪崩引发闩锁。图2-7显示,IGBT元包内部有PNPN四层结构,雪崩电流超过临界值,就必定触发晶闸管发生闩锁。
GATH不会雪崩引发闩锁。图2-8显示,GATH的栅区P+与元包内部连接,雪崩电流被P+统统抽走,不经过PNPN四层结构,不触发晶闸管,所以,不会闩锁。

图2-7 IGBT内部NPNNP结构导致闩锁 图2-8 GATH深栅P+结构
2.3 逆导型GATH
GATH适合硬开关的高压大功率逆导型。GATH没有闩锁问题,鲁棒性强,能够做成适用于硬开关的高压大功率逆导型产品。
逆导型,为了解决电流折拐,必定造成横向电场不均匀,从而加重了IGBT的闩锁。因此,IGBT不适合做高压大功率硬开关的逆导型。
根据ABB的规格书,RCIGCT只能够工作在零度以上,不能够在零度以下工作。IGCT因为元包太大,开通必须两次,才能够充分开通,低温环境更难充分开通。而逆导型RCIGCT,集成的二极管能把一部分开通驱动电流拉走。使得开通电流更小,零度以下,即使开通两次,也不能充分开通。所以,逆导型RCIGCT不能在零度以下工作。
RCGATH元包细微,驱动内阻小,零度以下,也能够造成开通。
2.4 联栅的技术来源
联栅技术来源于几个方面:独创的深栅P+替代栅铝、传统的联栅晶体管GAT、IGCT和FS IGBT、超高速双极型IC。
2.4.1独创的深栅P+替代栅铝
联栅技术采用独创的深栅P+替代栅铝,即栅区上面没有铝,只在栅区汇流条上面布铝,元包缩小到~10µm(碳化硅基联栅功率管~3µm)。从而获得了高可靠。
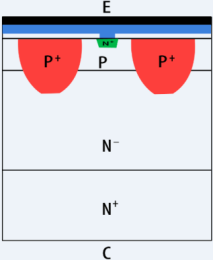
图2-9联栅结构示意图
联栅结构五个基本特征:
(1)发射极金属层下面是掺杂多晶硅,掺杂多晶硅下面连接发射区,发射区下面是基区和栅区(浓基区)
(2)栅区与发射极金属层正交
(3)栅区上面不连接栅极金属层
(4)栅区从侧下面引出到栅区汇流条再连接栅极金属层
(5)元胞13μm
2.4.2传统联栅晶体管GAT
传统GAT是一种SIT/BJT的复合型功率器件,在BJT的两侧设有深栅P+的低阻通道,有利于提高开关速度,并增强可靠性。
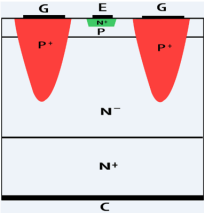
图2-10 传统GAT管结构示意图
2.4.3 IGCT和FS IGBT
IGCT和FS IGBT的FS缓冲层和透明阳极(IGBT叫做透明
集电极),能够降低导通电阻、提高关断速度。联栅晶闸管GATH吸收采用了这两项技术。
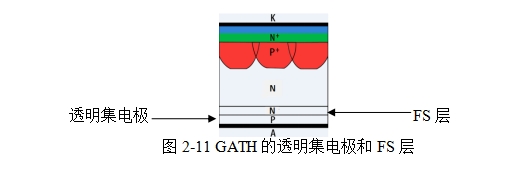
图2-11 GATH的透明集电极和FS层
2.4.4超高速双极型IC
联栅功率管采用了超高速双极IC的多晶硅发射极技术,增大了复合,减小了关断瞬间的电流拖尾,获得了高速度。

图2-12 GATH的多晶硅发射极
多晶硅发射极来源于双极型超高速IC的技术。多晶硅发射极超高速IC只用于小功率小电流,而联栅功率管则将多晶硅发射极应用于大功率大电流,获得了高开关速度和高频率。
联栅晶闸管GATH在与IGBT相同的电流密度下,关断速度更快,拖尾更小。如附图2-13、2-14所示。1200V GATH可工作在20KHz。
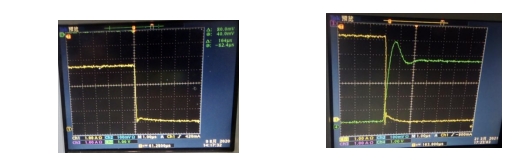
图2-13 GATH(X方向 1uS/格) 图2-14 IGBT(X方向 1uS/格)
在多晶硅发射极与硅衬底之间的界面上存在大量的高密度的复合中心,加速了载流子的复合,使联栅功率管电流拖尾减小,关断加快,从而获得高频。
2.5 联栅功率管工艺2.5.1联栅功率管工艺平台

图2-15联栅功率管工艺平台
2.5.2 联栅功率管工艺流程

图2-16 联栅功率管工艺流程图
2.5.3 4500V RCGATH器件的开发2.5.3.1目标
孵化项目在6吋线工艺基础上,开发逆导型(集成二极管)RCGATH 4500V/150A芯片;封装4500V/1800A焊接模块,4500V RCGATH模块测试试验。
2.5.3.2内容
1、高抗冲与低损耗良好折衷特性RCGATH芯片技术、低反向恢复峰值电流与低正向压降良好折衷特性的集成续流二极管芯片技术;自动均流的高芯片参数收敛性芯片技术研究;
2、4500V/1800A焊接型RCGATH器件
3、4500V/1800A焊接型RCGATH模块测试试验
2.5.3.3研发内容
课题1:高抗冲与低损耗良好折衷特性RCGATH芯片技术、低反向恢复峰值电流与低正向压降良好折衷特性的集成续流二极管芯片技术;自动均流的高芯片参数收敛性芯片技术研究
主要研究内容:
(1)高抗冲与低损耗良好折衷性能的RCCATH芯片技术研究
芯片产出单管封装后进行抗冲的极限考核与电流输出特性的考察。抗冲的极限考核包括过电压极限考核、短路极限考核与控制极限考核。过电压极限考核即过电压幅度与冲击次数极限考核;短路极限考核即短路电流的大小与持续时间长短的极限考核;控制极限考核即能够关断的最大电流考核。
栅区汇流条越宽,带宽越窄,则抗冲击能力越强,而电流能力则越弱,即饱和压降越高。反之亦然。要用实验数据和曲线来确定二者的良好折衷,从而确定“带宽/栅区汇流条”的版图设计基本规则。
栅区越宽,发射区越窄,则抗冲击能力越强,而电流能力越弱,即饱和压降越高。反之亦然。要用实验数据和曲线来确定二者的良好折衷,从而确定“发射区宽度/栅区宽度”的版图设计基本规则。
(2)低反向恢复峰值电流与低正向压降良好折衷的集成续流二极管芯片技术研究
A.设计2-4种不同阳极图形(不同密度、不同P+/P比例)的版图。
B.设计2种不同阴极图形(不同密度、不同尺寸)的版图。
通过芯片产出,封装单管,测量反向恢复特性曲线和正向输出特性曲线,确定同时兼顾低反向恢复峰值电流、反向恢复软度好而且正向压降低的版图参数。
(3)自动均流程度和规律调查,芯片电参数收敛性0.1V
A.电流输出特性曲线与驱动电压的关系
B.电流输出特性曲线与管温的关系
C.电流输出特性曲线与掺杂(两种扩磷条件,两种扩硼条件的关系)
通过A、B、C,摸清模块内多管芯并联的电流自动均流和多模块并联的电流自动均匀的程度和规律。做到在工作点附近,芯片的电参数收敛系数0.1V。
设计并制作焊接型4500V/150A RCGATH芯片,为4500V/1800A焊接型RCGATH模块做准备。
预期目标:
实现高抗冲低损耗良好折衷,低反向恢复峰值电流与低正向压降良好折衷,基本上能够自动均流的高参数收敛性的RCGATH芯片。
考核指标:
(1)RCGATH芯片封装单管后检测,达到在双倍额定电流下持续10mS(IGBT持续1mS), 短路时间100μS(IGBT 10μS)。
(2)VSDsat收敛性0.1V,芯片良率e 80%。
(3)发表三大检索或核心期刊论文2篇,申请发明专利 2项。
课题2:4500V/1800A焊接型RCGATH器件
考核指标:
(1)4500V/1800A焊接型RCGATH器件设计方案1套;
(2)4500V/1800A RCGATH模块电流3600A持续开通时间10mS后;能够关断(IGBT持续时间1mS);短路耐受时间100μS(IGBT 10μS)。PC 功率循环能力e 1 万次(结温差80K),温度循环能力e 100 次(-40℃~125℃ ),温度冲击能力e 100 次(-40℃~125℃ )。
课题3:4500V/1800A焊接型RCGATH模块测试试验
主要研究内容:
(1)研究4500V/1800A焊接型RCGATH静态特性、动态特性、安全工作区测试方案,搭建大电流测试平台;
(2)研究适用4500V/1800A焊接器件的关键可靠性测试方法,完成器件级可靠性试验评估;
预期目标:
具备 4500V/1800A焊接器件的静、动态特性及可靠性测试能力,支撑课题 1、2 相关优化;提出4500V/1800A焊接器件的关键可靠性测试方式并评估产品可靠性。
2.5.4 6500V GATH设计2.5.4.1研制目标
表2-1 4500V GATH主要技术指标


本项目产品是6500V,600A的IGBT模块,可靠性指标执行《半导体分立器件模块通用规范》(报批稿)JM1级编制及考核控制要求,此项目主要从模块套件和焊料选取方面进行设计,可靠性指标可以达到军用分立器件详细规范编制及考核控制要求。
2.5.4.2 电参数
表2-2 6500V GATH与IGBT电参数对比表
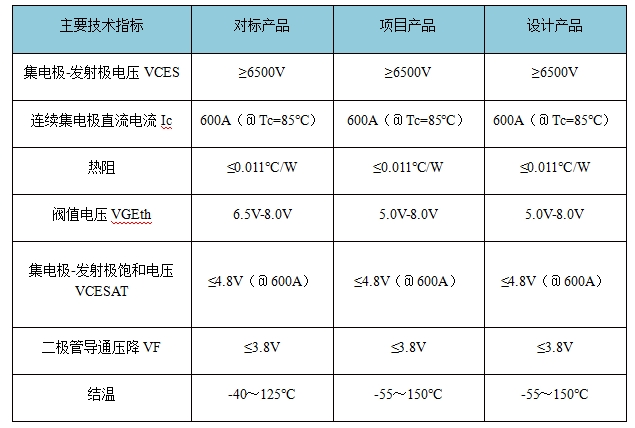
2.5.4.3产品研制方案2.5.4.3.1产品设计
参数设计
GATH芯片产品已经很成熟:有源区的设计已经定型;适用于各种耐压规范和电流规范;终端结构也很成熟。
6500V 600A 产品只需要变更衬底电阻率厚度、终端宽度即可。参考公开资料,选取电阻率在550-700欧姆厘米。终端宽度取3000微米。终端形式为POLY-AL 双场板+场限环。只需要撒网调整环间距、场板宽度。
表2-3 6500V GATH设计指标

2.5.4.3.2 技术分析与把握 2.5.4.3.2.1关键技术和技术难点分析
研制产品在6英寸线的最大管芯尺寸为14mm*15mm。必须在一个管芯内电流达到50A且耐压达到6500V,电流越大越好。
研制产品的难点在于6500V耐压和最大电流的折中。终端越宽,衬底越厚,耐压越高,但是,最大电流越小。反之,终端越窄,衬底越薄,最大电流越大,耐压越低。
6500V GATH做逆导型GATH。IGBT由于闩锁天花板,高压大电流芯片很难集成续流二极管。GATH无闩锁,集成FRD可靠性更高,成本更低。
2.5.4.3.2.2技术难点及解决途径
1 、击穿电压 6500V(由衬底电阻率和终端决定)
1) 衬底选择
衬底电阻率参考 6500V IGBT/IGCT 电阻率 370---700欧姆厘米 达到7000V
GATH衬底电阻率 500-600欧姆厘米/衬底高阻层厚度 580微米---680微米/最终取 650微米
2)终端确定
A.采用双场板+场限环 宽度 3000微米
B.备用 多区 JTE 终端
JTE 终端2000微米能够达到6500V。JTE 对表面电荷十分敏感,稳定量产,取决于工艺线的控制水平。
2、FS层
GATH的FS层是在减薄之后通过注H形成
6500V 600A 的衬底厚,可以先做背面FS层先做背面工艺比较稳妥可靠。
3、逆导型
逆导型,集成二极管,没有连线,更加可靠。
由于闩锁,IGBT的高压大功率产品不能做逆导型。逆导型,必定带来横向电场的不均匀,更容易发生闩锁。因此,IGBT的逆导型,仅仅能够用于低压小功率的软开关。
GATH无闩锁问题,其抗毁损能力是IGBT的10倍。所以,能够应用与高压大功率硬开关。
总结:
终端为POLY-AL双层场板+场限环,宽度为3000微米,对环的间距、场板宽窄做处理。通过撒网试验,取最佳的耐压与最大电流折中。
同时,做JTE终端试验。JTE终端,能够以最小的宽度达到最高的耐压。但是,对表面很敏感,即对工艺的要求很高。JTE能够用2000微米宽度做6500V
我们的终端水平是很高的。国外1700V产品,用场板+场限环,需要850微米。
我们只用650微米,做到2000V以上。
我们用450微米宽度的JTE,达到2200V的耐压。
声明:本内容为作者独立观点,不代表电源网。本网站原创内容,如需转载,请注明出处;本网站转载的内容(文章、图片、视频)等资料版权归原作者所有。如我们采用了您不宜公开的文章或图片,未能及时和您确认,避免给双方造成不必要的经济损失,请电邮联系我们,以便迅速采取适当处理措施;欢迎投稿,邮箱∶editor@netbroad.com。
| 联栅晶闸管GATH-应用场景与结论 | 25-03-20 10:05 |
|---|---|
| 联栅晶闸管GATH-驱动特性与可靠性实验 | 25-03-20 09:55 |
| 联栅晶闸管GATH-电气特性 | 25-03-20 09:42 |
| 联栅晶闸管GATH-概述 | 25-03-14 11:50 |
| 一种新型IGCT——GATH | 21-03-05 14:00 |